深度解析Wafer晶圆半导体工艺(2023精华版)
关键词:
发布时间:2023-05-09
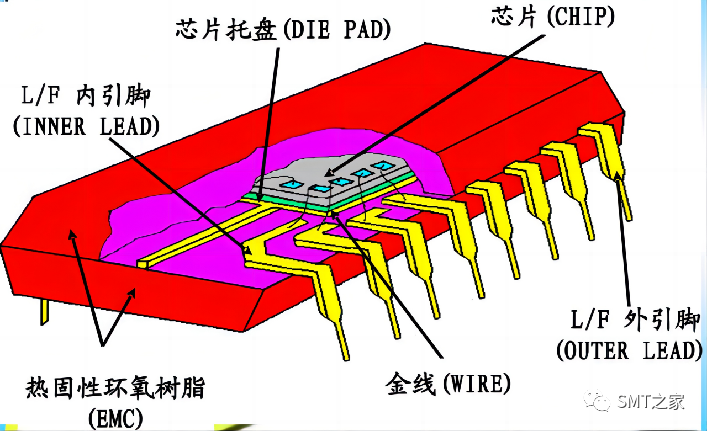

工艺流程(Process flow):
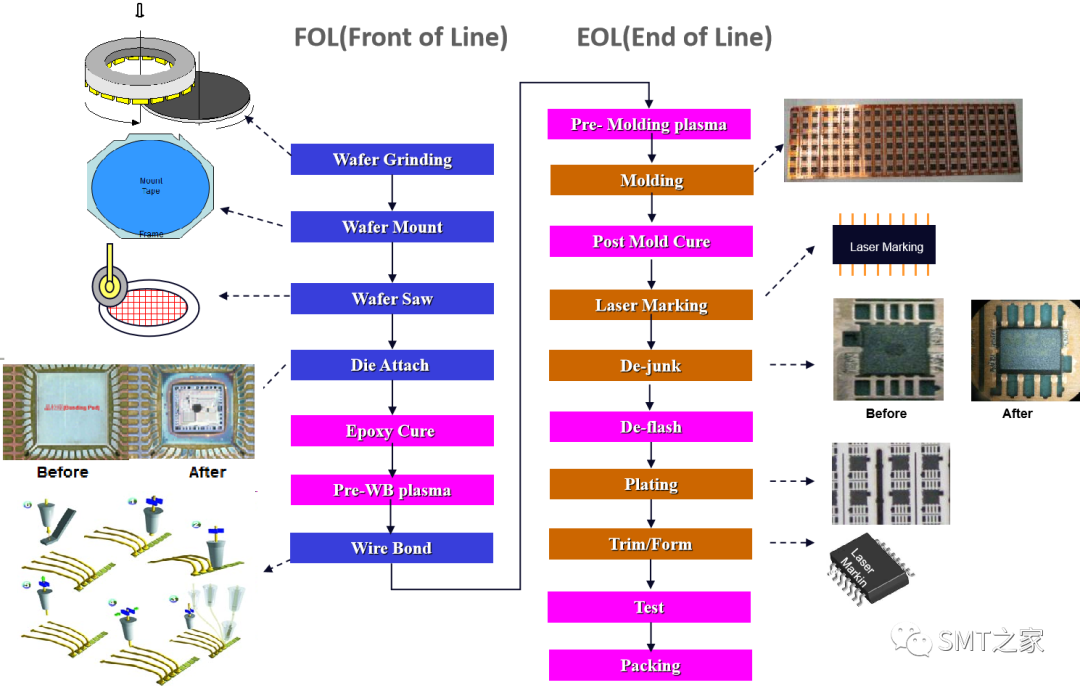
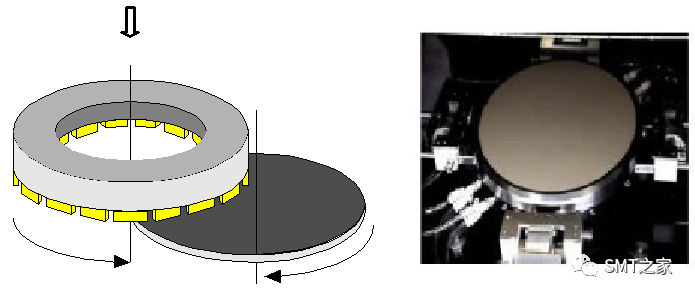
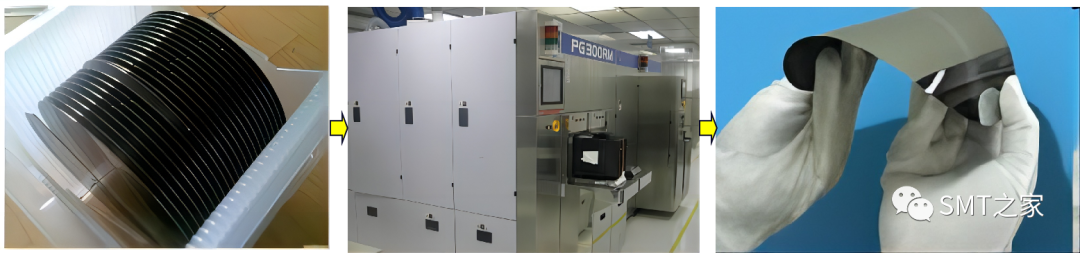









































































 二焊点不良:第二焊点根部有撕裂或隐裂现象
二焊点不良:第二焊点根部有撕裂或隐裂现象




 After Mold
After Mold




 孔洞
孔洞 缺角
缺角 上下错位
上下错位 溢胶
溢胶 弧度不良:焊线冲歪率大于20%
弧度不良:焊线冲歪率大于20% C-SAM 检查
C-SAM 检查 固化烤箱Oven
固化烤箱Oven













 晶须(Whisker),是指锡在长时间的潮湿环境和温度变化的环境下生长出的一种须状晶体,可能导致产品引脚的短路。
晶须(Whisker),是指锡在长时间的潮湿环境和温度变化的环境下生长出的一种须状晶体,可能导致产品引脚的短路。 外观检查
外观检查 镀层厚度量测
镀层厚度量测 可焊性测试Solderability test
可焊性测试Solderability test







来源:SMT之家、芯ONE
工程案例

广西盛百汇电子厂房净化工程案例
2023-11-28

佛山方普防护技术无尘车间净化工程案例
2023-07-26

化妆品洁净厂房装修工程
2023-05-22

标准化无尘中式快餐配送中心建设项目
2023-05-22

保健品、化妆品、日用品厂房净化工程
2023-05-22
相关新闻

关于定期清洗更换过滤器及冬季防冻的措施提示
2023-11-15

喜报!热烈祝贺广东某二类医疗器械厂房净化工程成功签约
2023-09-21

镇江无尘车间装修公司 芯片制造电子无尘车间的要求
2023-07-28

合肥无尘车间装修公司 电子无尘车间异物降低的办法
2023-07-28

合肥电子无尘车间PVC防静电地板的施工方法
2023-07-21











